マスクレス露光装置 PALET
この度、新製品マスクレス露光装置「PALET」の取り扱いを始めました。
本製品は、業界最安クラスの卓上型露光装置です。
設置面積はA3サイズに収まり、省スペースでの設置が可能です。
また、必要な電源は家庭用コンセント(AC100V)のみで、特別な電源工事も不要です。
直感的な操作画面により、初心者の方でも簡単にパターニングを行うことができます。
評価デモも可能ですのでお気軽にお問い合わせください。
担当:前田、生稲
マスクレス露光装置 PALET
この度、新製品マスクレス露光装置「PALET」の取り扱いを始めました。
本製品は、業界最安クラスの卓上型露光装置です。
設置面積はA3サイズに収まり、省スペースでの設置が可能です。
また、必要な電源は家庭用コンセント(AC100V)のみで、特別な電源工事も不要です。
直感的な操作画面により、初心者の方でも簡単にパターニングを行うことができます。
評価デモも可能ですのでお気軽にお問い合わせください。
担当:前田、生稲
マスクレスでフォトリソグラフィができる卓上型の露光装置です。
装置本体の設置面積はA3サイズとなり、必要ユーティリティもAC100Vのみです。
またユーザーフレンドリーな操作性で、フォトリソグラフィに慣れない人でもパターニング可能です。
価格に関しても、機能の絞り込みを行うことで圧倒的な低価格となっております。
・マスクレスでフォトリソグラフィができる
フォトマスクの代わりにDMD(デジタルマイクロミラーデバイス)を使用しています。
手軽にリソグラフィができる為、研究用途やフォトマスク作成前の試作用としてもご利用可能です。
・設置面積の少ない卓上型
装置本体の設置面積はA3サイズとなり、ほかにノートPCとステージドライバが付属します。
・必要ユーティリティはAC100Vのみ
フローティング構造を採用し、振動を抑制している為、防振台が不要です。
真空吸着ポンプも内蔵している為、圧縮エアや冷却水も必要ございません。
・圧倒的な低価格
機能を絞り込むことで、圧倒的な低価格を実現いたしました。
・ユーザーフレンドリーな操作性
手軽に使用して頂くために、フォトリソグラフィに不慣れな人でもパターニングできる、
分かりやすいユーザーインターフェイスとなっております。
| 品名 | 手動ステージモデル | 電動ステージモデル | 大型ステージモデル |
|---|---|---|---|
| 型名 | DDB-701-MS | DDB-701-DL | DDB-701-DL4 |
| ステージ | 手動 XYZθステージ | 電動 XYZθステージ | |
| 構成 (共通) | 装置本体・制御用PC・ソフトウェア | ||
| 構成 (モデル) | ― | ステージドライバ | ステージドライバ・ 防振テーブル |
| 光源 | 365nm(typ.)LED | ||
| 露光領域 | 25mm × 25mm | 100mm × 100mm | |
| ワークサイズ | 最大Φ60mm、 厚み3mm | 最大Φ150mm、 厚み10mm |
|
| ユーティリティ | AC100V、消費電力 1.5kW以下 | ||
| 対応ファイル形式 | 画像データ(JPEG / PNG / BITMAP)、パワーポイントデータ(XPS)、 CADデータ(DXF) |
||
| 本体外寸(mm)・質量 |
300
(W) × 450 (D) × 450 (H) 約30kg |
500
(W) × 600 (D) × 650 (H) 約100kg |
|
| 対物レンズ | 10倍 | 2倍 |
|---|---|---|
| 最小露光線幅 | 3μm | 15μm |
| ワンショットあたりの露光エリア | 約1mm × 約0.6mm | 約5mm × 約3mm |
| ワンショットあたりの露光時間 (※1) | 約1秒 | 約15秒 |
※1 PALET標準フォトレジストでの参考値となります。
使用方法
電話番号:03-3836-2800
担当:生稲、前田
もしくは下記お問い合わせフォームまで
フォームが表示されるまでしばらくお待ち下さい。
恐れ入りますが、しばらくお待ちいただいてもフォームが表示されない場合は、こちらまでお問い合わせください。

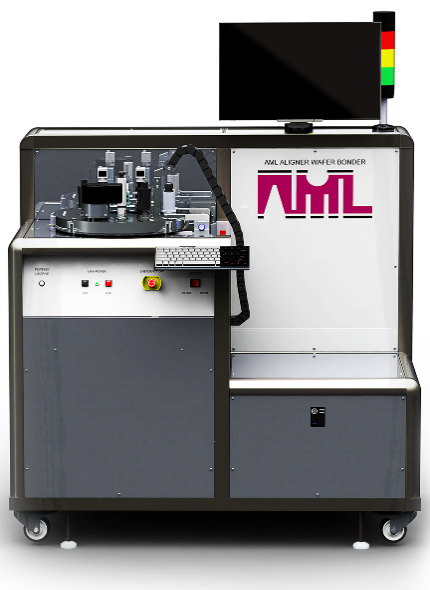
研究開発に特化し様々な接合が可能なワンチャンバー
In-SItuアライメントのウエハ接合装置
研究開発ウエハ接合に特化した 英国 APPLIED MICROENGINERERING 社のウエハ接合装置。
1µm精度の光学アライメントにより、高い歩留まりと優れたウエハ接合を実現。
多様なボンディング技術に対応しており、研究開発・試作開発に適したプロセスマージンの広いウエハ接合装置。
複数サイズのウエハ(小片から8インチまで)に対応し、超極真空条件下(10-8mbar = 1 × 10-6 Pa)でのウエハ接合にも対応 (ROCKタイプ)。
チャンバー内部構成
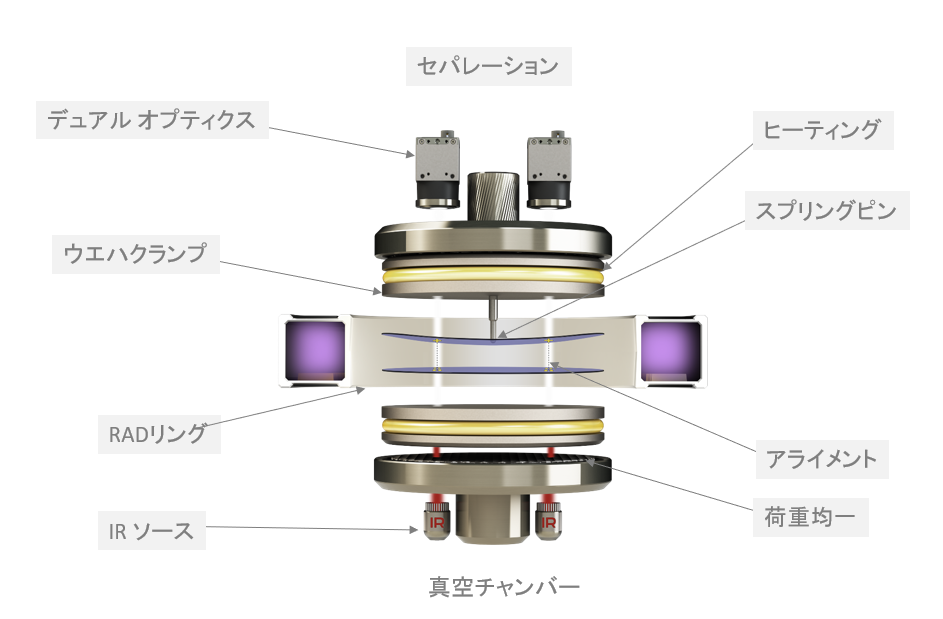
ROCK
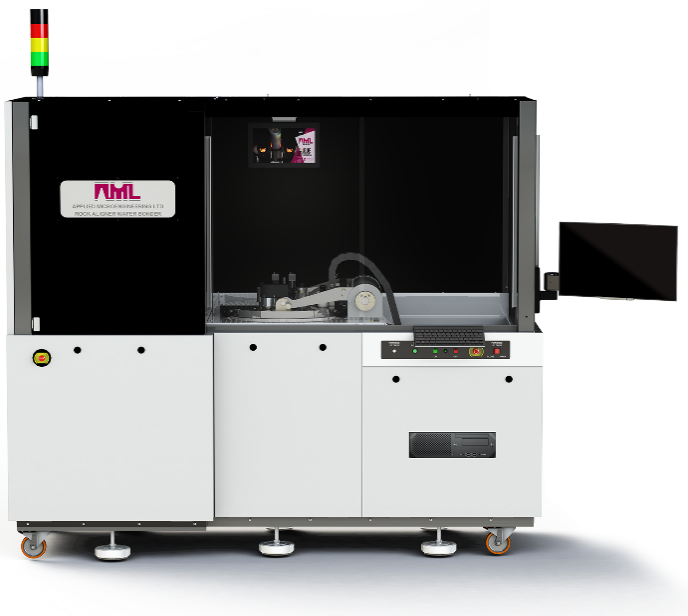
ライブビュー機能
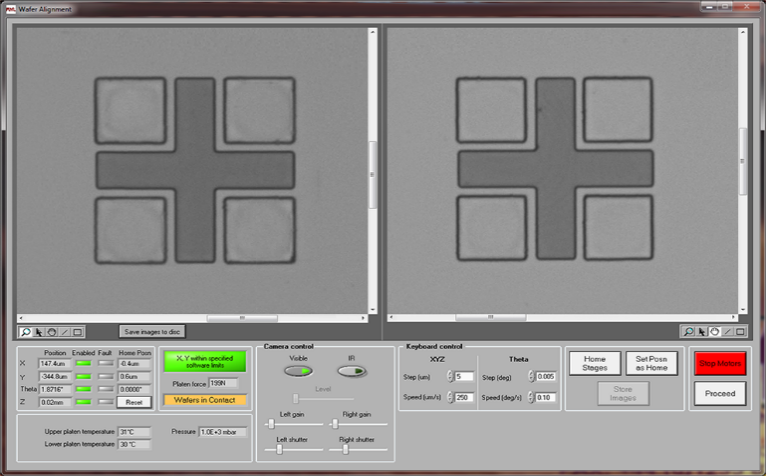
アプリケーション
| AWB | ROCK | |||
|---|---|---|---|---|
| 装置タイプ | AWB-04 | AWB-08 | ROCK-04 | ROCK-08 |
| 対象ウエハサイズ | 3、4、6 インチウエハ |
6、8 インチウエハ |
3、4、6 インチウエハ |
6、8 インチウエハ |
| アライメント精度 | 1µm | |||
| チャンバー内圧 | 10⁻⁶mbar – 2 bar | 10⁻⁸mbar – 2 bar | ||
| プラテン温度 | 最大 560℃ | |||
| 接合圧 | 最大40kN (約4トン) | |||
| 陽極接合電圧 | 最大2.5kV | |||
| チップ接合 | 対応 | 非対応 | 対応 | 非対応 |
| 装置サイズ | 1,230(L)×832(W)×1,704(H) mm | 2,110(L)×915(W)×2,242(H) mm | 1,230(L)×832(W)×1,704(H) mm | 2,110(L)×915(W)×2,242(H) mm |
| 付帯設備 | – | – | ヘリウム圧縮機 : 450(L)×660(W)×565(H) mm | ヘリウム圧縮機 : 450(L)×660(W)× 565(H) mm |
| オプション |
UV硬化 近赤外線カメラ |
|||
| ユーティリティ | 電源:100VAC CDA:バルブ駆動用 N2ガス:チャンバー充填、 プラテン/ウエハ冷却 プロセスガス:供給可能 |
電源:100VAC CDA:バルブ駆動用 N2ガス:チャンバー充填、 プラテン/ウエハ冷却 プロセスガス:供給可能 |
電源:100VAC、3相 CDA:バルブ駆動用 N2ガス:チャンバー充填、 プラテン/ウエハ冷却 プロセスガス:供給可能 ヘリウム圧縮機:400V 3相 (50Hz) or 460V 3相 (60Hz) |
電源:100VAC、3相 CDA:バルブ駆動用 N2ガス:チャンバー充填、 プラテン/ウエハ冷却 プロセスガス:供給可能 ヘリウム圧縮機:400V 3相 (50Hz) or 460V 3相 (60Hz) |
フォームが表示されるまでしばらくお待ち下さい。
恐れ入りますが、しばらくお待ちいただいてもフォームが表示されない場合は、こちらまでお問い合わせください。


ウエハ歪み(位相差・位相軸方位)の全面評価
独自の偏光カメラを使用することでウエハの全面評価を短時間でかつ定量評価することが可能な装置です。
ウエハの内部歪み・加工応力の定量化ができます。
対象となるウエハは、SiC、GaN、人工ダイヤモンドウエハ。
GaAsウエハも赤外線波長を使用することで、測定可能(PA-300-NIR)。


SiC 8inch(オフ角 4度)

GaN 3inch 位相差表示

GaN 3inch 結晶軸方位

モノクロ輝度画像

結晶欠陥データ

GaAs 位相差表示
| PX-300-XL | PA-300-L | PA-Micro | |
|---|---|---|---|
| 特徴 | A3サイズまで測定 | A4サイズまで測定 | 顕微鏡視野まで測定 |
| 測定視野 | 242×290 mm ~ 360×480 mm |
37×44 mm ~ 240×320 mm |
140×170 µm ~ 3.5×4.2 mm |
| オプションレンズ視野 | 対応不可 | ズーム 5.5×6.6 mm ~ 25×30 mm |
×100 40×53 µm |
| 出力される数値 | 位相差(nm)・軸方位(°) | ||
| 測定レンジ | 0~130 nm | ||
| 繰り返し再現性 | σ < 0.1 nm | ||
| 測定波長 | 520 nm | ||
| 筐体サイズ | 650×600×1930 mm | 430×487×1166 mm | 270×500×610 mm |
| 重量 | 46 Kg | 23 Kg | 18 Kg |
| 構成 | 本体 PC(ソフトウェアインストール) 説明書など書面 ※PA-microの場合、顕微鏡一式 |
||
フォームが表示されるまでしばらくお待ち下さい。
恐れ入りますが、しばらくお待ちいただいてもフォームが表示されない場合は、こちらまでお問い合わせください。


非破壊・非接触・超高速全面マッピング
自然酸化膜やレジスト膜などの薄膜の膜厚/屈折率の測定。
独自開発のPCAセンサにより、最大毎分20,000点以上のハイスピードで高精度に膜厚の面内分布が測定可能です。
ウエハサイズは8インチ(オプションで12インチ)まで対応可能、SMIFポッド対応し、研究開発から量産まで対応しております。
0.1nm(1Å)レベルの膜厚ムラの測定も可能、透明基板にも対応しております(ME-210-T)。
ウエハ表面酸化膜の膜厚分布

2mm間隔測定(測定時間約3分)
測定時間を短時間にすることで、枚数が多い場合や全体傾向を短時間で取得可能です。

0.5mm間隔測定(測定時間約33分)
測定間隔を狭くすることで、ウエハ全体の詳細な膜厚分布情報を取得することが可能です。

透明基板上の膜厚分布
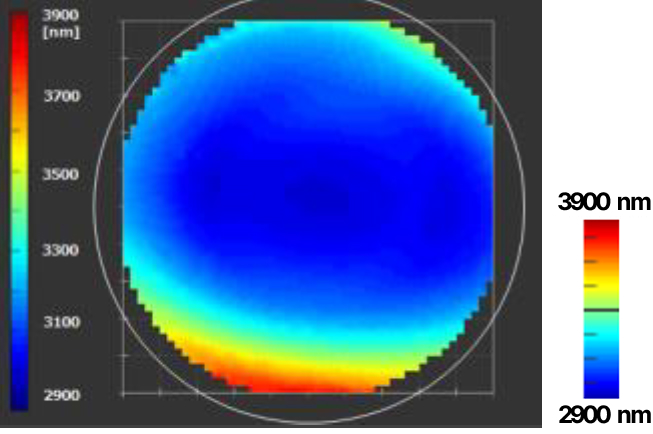
スピンコートしたレジスト膜厚分布

有機層の膜厚分布
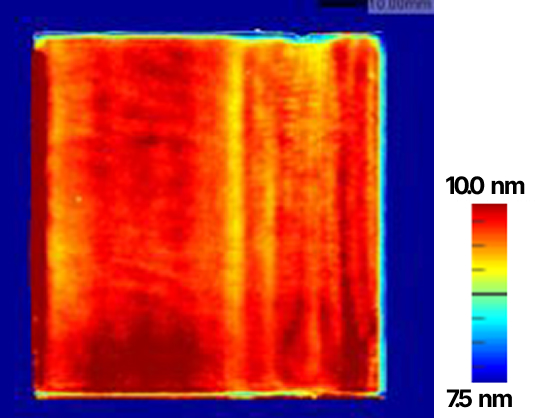

高速・低価格・コンパクトなエリプソメータ
独自センサ搭載によるコンパクトな設計かつ拡張性の高い、卓上型点測定装置。
従来のエリプソメータは、偏光子を回転させる駆動系仕様となり、装置が大型になり、コンパクトなサイズでの装置設計。
最速1/70秒間隔のリアルタイムの測定が可能であり、膜厚の時間変動解析にも有効です。
ヘッドユニットを取り外したモジュールとしても活用できます。
| ME-210 | ME-210-T | SE-101 | |
|---|---|---|---|
| 測定方式 | PCA(フォトニック結晶アレイ並列処理)方式 | ||
| 測定再現性 | 膜厚:0.1nm、屈折率:0.001 | ||
| 光源 | 半導体レーザ(typ. 636 nm) | ||
| 測定スポット |
広域モード:550 µm角 中間モード:55 µm角 高精細モード:5.5 µm角 |
約1.0 mm角 | |
| 入射角度 | 標準70度 | ||
| ステージサイズ | 最大8インチウエハ対応 | 最大4インチウエハ対応 | |
| 透明基板対応 | – | 〇 | – |
| 測定速度 |
最高毎分20,000点以上 (高精細測定時) |
約0.1秒 / 1測定点 | |
| 本体寸法 |
幅:650 mm 奥行き:650 mm 高さ:1,740 mm |
幅:250 mm 奥行き:175 mm 高さ: 220 mm |
|
| 重量 | 約 120 kg | 約 4 kg | |
| 製品内容 |
システム1式 ソフトウェア(インストールCD) 標準サンプル 取扱説明書 |
||
フォームが表示されるまでしばらくお待ち下さい。
恐れ入りますが、しばらくお待ちいただいてもフォームが表示されない場合は、こちらまでお問い合わせください。


DL81/DL82は、Logitechの最新鋭かつ高度自動化された高荷重対応のラッピング・ポリッシング装置です。2つの自動ワークステーションを搭載し、インテリジェントな空圧式研磨治具により、多様な材料の加工において非常に高い精度と再現性を実現します。研究用途からプロセス開発、生産ラインまで幅広く対応可能です。
精密研磨を行う場合、研磨を行う側であるラッピングプレートの平坦度が悪くては意味がありません。
ロジテック社の研磨装置では、研磨を行う前に必ずラッピングプレートの平坦度を測定し、ノウハウを活かした独自技術で平坦度出しを行います。研磨の目的によっては、意図的に形状を変化させることもございます。
平坦度モニターにより、リアルタイムでプレートの形状を0.1um分解能でモニターし、設定したターゲットの形状になるように、自動でプレート自体を研磨し、形状を補正することが出来ます。
例えば、コントロールパネルでTarget Flatness(ターゲット平坦度)を1umに設定すると、プレートの平坦度が1umになるまで、自動的にプレートを研磨し補正することが出来ます。
これにより、プレートの平坦度出しに掛かる時間を大幅に短縮することが可能になりました。
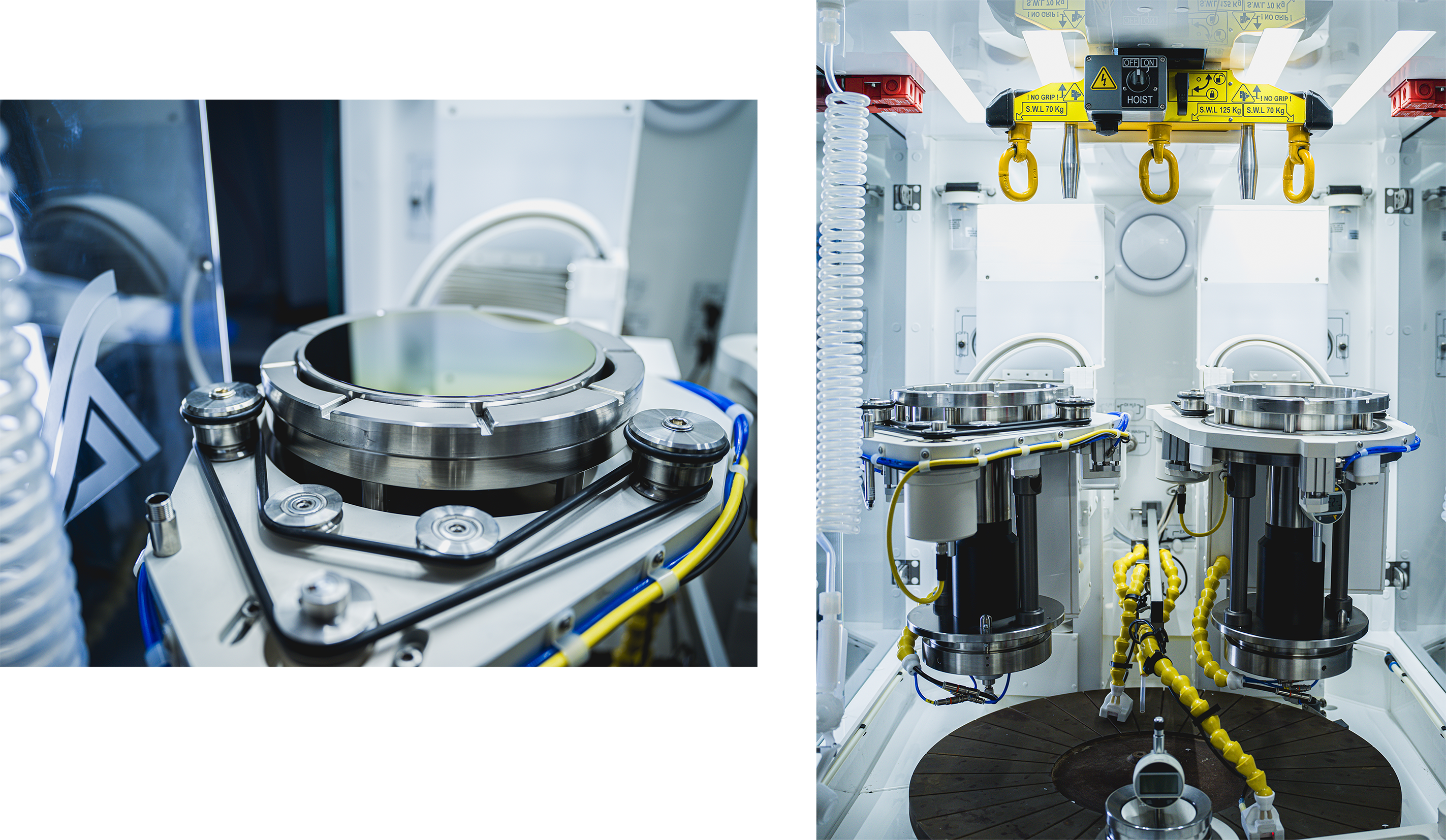
研磨プレートやポリッシングパッド、スラリーなど高精度な研磨に必要な消耗品は全てご用意しております。
ご希望の研磨仕様に最適な装置とアイテムを総合的にご提案致します。
| プレート径 | 最大700 mm |
| 対応治具タイプ | DL82:AJ200(8″)、AJ150(6″)、AJ100(4″) x2式 DL81:AJ200(8″)、AJ150(6″)、AJ100(4″) x1式 |
| 対応ウェハサイズ | 2インチ~8インチ |
| プレート回転速度 | 最大100 rpm |
| 研磨治具回転速度 | 最大100 rpm |
| 研磨治具荷重範囲 | 2~40kg |
| スラリー流量 | 5〜100 ml/min |
| 廃液処理 | 密閉式 Logiwasteシステム |
| 排気ポート | 150 mm OD |
| 電源 | 単相AC 220–240V / 32A |
| 寸法(W×D×H) | 1141 x 1639 × 1975 mm |
フォームが表示されるまでしばらくお待ち下さい。
恐れ入りますが、しばらくお待ちいただいてもフォームが表示されない場合は、こちらまでお問い合わせください。


国内販売実績 50台以上
研究開発に最適なベストセラーRTAシステム
AccuThermoシリーズ高速熱処理装置は、強力な可視~赤外光照射により、最大1250℃、昇温速度150℃/secでウェハの加熱処理を行う赤外線ランプアニール装置(RTP・RTAシステム)です。
AccuThermo AW610Mは最大6インチウェハ、または2インチウェハ×4枚、3インチウェハ×3枚、156mm角PVセルのアニール処理に対応可能な大気圧RTP・RTAシステムで、研究開発・試作用途のほか、小ロット生産にも対応する高性能・高信頼性ランプアニールシステムです。
 |
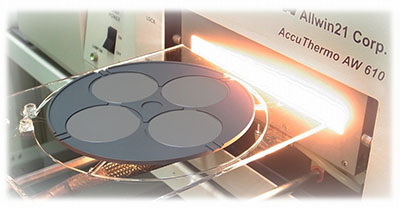 |
 |
| Si デバイス | 化合物半導体 | PVセル |
|---|

AccuThermoシリーズRTAシステムには組み込みボードPCおよびRTAProソフトウェアが標準搭載されており、グラフィカルなインターフェイス上で任意のアニールレシピの作成・保存・実行、および プロセスデータの管理を行うことができます。また、ソフトウェア上で熱電対回路やパイロメータ、チャンバー/ランプ等のキャリブレーションを容易に行うことができ、安定かつ再現性の高いアニールプロセスを実行できます。
| 項目 | 仕様 | |
|---|---|---|
| 対応基板サイズ | [標準] φ3インチ ~ φ6インチ [オプション] φ2インチ ~ φ4インチ [オプション] 156mm × 156mm 角型基板 [オプション] サセプタ使用時:個片チップ~φ6インチ |
|
| 温度制御範囲 | TC | 100℃ ~ 800℃ |
| [Option] Special-TC | 100℃ ~ 1050℃(*1) | |
| [Option] パイロメータ | 450℃ ~ 1250℃(*1) | |
| 加熱方式 | 赤外線ランプ放射加熱(1.2kW×21本,Top 10、Bottom 11) | |
| 冷却方式 | ガスパージによる強制空冷 | |
| 加熱方向 | 上下面2方向 | |
| 温度制御方式 | 検出温度フィードバックによるクローズドループ制御 | |
| 昇温速度 | 10℃/sec ~ 150℃/sec(*1) | |
| 降温速度 | 10℃/sec ~ 150℃/sec(*2) | |
| 温度測定精度 | TC:±1℃(校正後),ERPパイロメータ:±4℃(校正後) | |
| 面内温度均一性 | ΔT 10℃(*1) | |
| ランプゾーン数 | 6ゾーン独立制御 | |
| 試料ローディング方式 | フロントローディング(手動) | |
| プロセス処理室、試料搭載部 | 石英チューブ、石英トレイ | |
| チャンバー材質 | アルミニウム合金 + 拡散反射Auコーティング | |
| チャンバー冷却方式 | 空冷・水冷併用 | |
| プロセスガス種 | N2、O2、He、Ar、フォーミングガス(水素濃度5%程度) その他のガス種はご相談ください |
|
| プロセスガス系統数 | [標準] 1系統(N2) [オプション] 最大4系統 |
|
| プロセスガス流量制御範囲 | [標準] 0.2slpm ~ 10slpm (MFCによる制御) [オプション] 20sccm ~ 1000sccm (MFCによる制御) 他 |
|
| 登録レシピ数 | 制限なし | |
| レシピ当たりのステップ数 | 最大40ステップ (サイクリックアニールの場合、最大99ループ対応) |
|
| プロセス制御方式 | 装置組み込みコンピューターボード、RTAProソフトウェア、17インチ液晶モニタ、キーボード、マウス | |
| ソフトウェアの主な機能 | リアルタイムプロセスモニタ レシピ編集、保存、読み出し プロセスデータリコール プロセスデータ出力(Txt形式) 各種キャリブレーション システム診断 etc. |
|
| 安全対策 | 非常停止SW、過昇温検出、冷却水監視、ドア開閉監視、ウォッチドッグタイマー etc. | |
| 外形寸法・重量 | W660 × D432 × H366 mm・50kg(*3) | |
*1 標準的なSiウェハによる代表値。試料の材質、熱容量により変動します。
*2 標準的なSiウェハによる代表値。試料の材質、熱容量により変動します。また物理的冷却速度に制限されます。
*3 装置寸法・重量には、周辺機器は含まれておりません。
| 項目 | 装置側接続形状 | 用力 |
|---|---|---|
| 電源(本体用) | M5端子台×3(RTS) 挿し込み式端子台×1(E) |
AC200V三相、50/60Hz、50A |
| 電源(パイロメータチラー用)* | 接地型2Pコンセント | AC100V、50/60Hz、5A |
| CDAまたはN2(冷却用) | 3/8”プッシュロック | 0.3[MPa]、283~425[L/min] ※3[um]のフィルタを通すこと |
| CDAまたはN2(アクチュエータ駆動用) | 1/4”Swagelok | 0.55[MPa]、30[L/min] |
| 冷却水 | 1/2”Swagelok (またはNPT3/8”) |
水温 15℃~35℃ 0.3~0.4[MPa]、7.62[L/min以上] ※100[um]のフィルタを通すこと ※DI水、蒸留水は使用不可 |
| プロセスガス | 1/4“VCR(Male) | 0.15[MPa]、10[slpm](標準) |
| キャビネット排気 | Φ101.6mm 短管 | 3000[slpm]以上 |
| ガスボックス排気 | Φ101.6mm 短管 | 3000[slpm]以上 |
| プロセス排気 | 1/4“VCR(Male) | - |
* ERPパイロメータオプションを選択した場合。
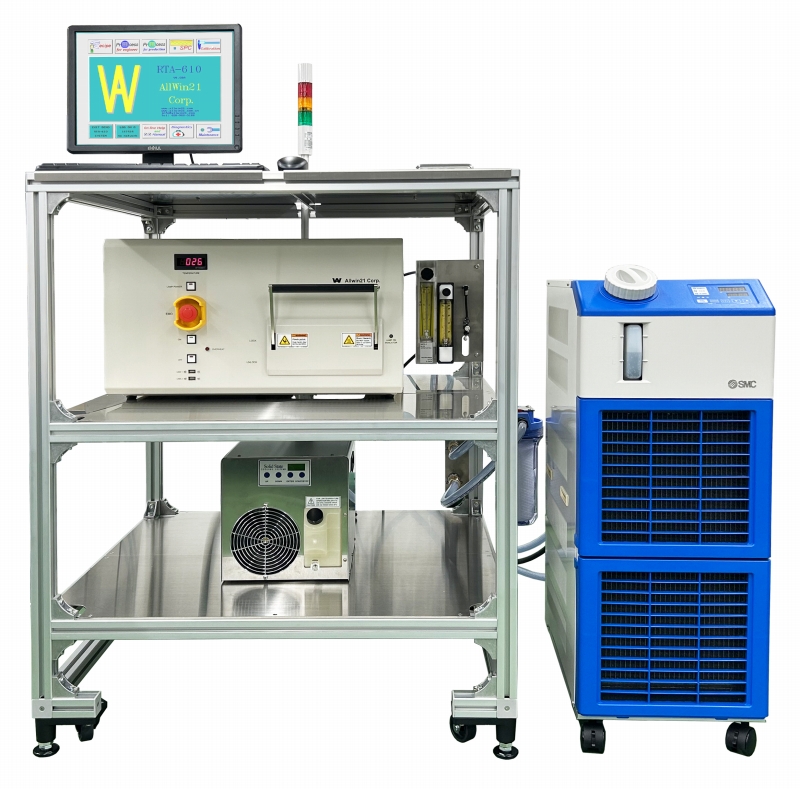
[組み込み対応機器]
フォームが表示されるまでしばらくお待ち下さい。
恐れ入りますが、しばらくお待ちいただいてもフォームが表示されない場合は、こちらまでお問い合わせください。


スタンドアローン・長時間プロセス
8インチ対応 RTAシステム
AccuThermoシリーズ高速熱処理装置は、強力な可視~赤外光照射により、最大1250℃、昇温速度150℃/secでウェハの加熱処理を行う赤外線ランプアニール装置(RTP・RTAシステム)です。
AccuThermo AW820Mは最大8インチウェハ、または2インチウェハ×16枚、3インチウェハ×5枚、4インチウェハ×4枚のアニール処理に対応可能な大気圧RTP・RTAシステムで、研究開発・試作用途のほか、小ロット生産にも対応する高性能・高信頼性ランプアニールシステムです。
 |
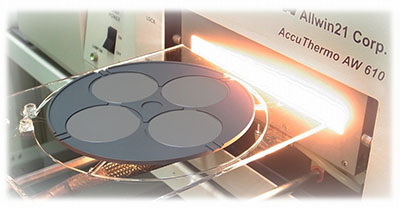 |
 |
| Si デバイス | 化合物半導体 | PVセル |
|---|
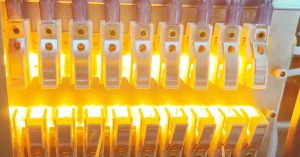
AccuThermoシリーズRTAシステムには組み込みボードPCおよびRTAProソフトウェアが標準搭載されており、グラフィカルなインターフェイス上で任意のアニールレシピの作成・保存・実行、および プロセスデータの管理を行うことができます。また、ソフトウェア上で熱電対回路やパイロメータ、チャンバー/ランプ等のキャリブレーションを容易に行うことができ、安定かつ再現性の高いアニールプロセスを実行できます。
| 項目 | 仕様 | |
|---|---|---|
| 対応基板サイズ | [標準] φ5インチ ~ φ8インチ [オプション] φ2インチ ~ φ4インチ [オプション] 200mm × 200mm 角型基板 [オプション] サセプタ使用時:個片チップ~φ8インチ |
|
| 温度制御範囲 | TC | 100℃ ~ 800℃ |
| [Option] Special-TC | 100℃ ~ 1050℃(*1) | |
| [Option] パイロメータ | 450℃ ~ 1250℃(*1) | |
| 加熱方式 | 赤外線ランプ放射加熱(1.5kW×27本,Top 13、Bottom 14) | |
| 冷却方式 | ガスパージによる強制空冷 | |
| 加熱方向 | 上下面2方向 | |
| 温度制御方式 | 検出温度フィードバックによるクローズドループ制御 | |
| 昇温速度 | 10℃/sec ~ 150℃/sec(*1) | |
| 降温速度 | 10℃/sec ~ 150℃/sec(*2) | |
| 温度測定精度 | TC:±1℃(校正後),ERPパイロメータ:±4℃(校正後) | |
| 面内温度均一性 | ΔT 10℃(*1) | |
| ランプゾーン数 | 10ゾーン独立制御 | |
| 試料ローディング方式 | フロントローディング(手動) | |
| プロセス処理室、試料搭載部 | 石英チューブ、石英トレイ | |
| チャンバー材質 | アルミニウム合金 + 拡散反射Auコーティング | |
| チャンバー冷却方式 | 空冷・水冷併用 | |
| プロセスガス種 | N2、O2、He、Ar、フォーミングガス(水素濃度5%程度) その他のガス種はご相談ください |
|
| プロセスガス系統数 | [標準] 1系統(N2) [オプション] 最大6系統 |
|
| プロセスガス流量制御範囲 | [標準] 0.2slpm ~ 10slpm (MFCによる制御) [オプション] 20sccm ~ 1000sccm (MFCによる制御) 他 |
|
| 登録レシピ数 | 制限なし | |
| レシピ当たりのステップ数 | 最大40ステップ (サイクリックアニールの場合、最大99ループ対応) |
|
| プロセス制御方式 | 装置組み込みコンピューターボード、RTAProソフトウェア、17インチタッチスクリーン、キーボード、マウス | |
| ソフトウェアの主な機能 | リアルタイムプロセスモニタ レシピ編集、保存、読み出し プロセスデータリコール プロセスデータ出力(Txt形式) 各種キャリブレーション システム診断 etc. |
|
| 安全対策 | 非常停止SW、過昇温検出、冷却水監視、ドア開閉監視、ウォッチドッグタイマー etc. | |
| 外形寸法・重量 | W978 × D1220 × H1780 mm・460kg(*3) | |
*1 標準的なSiウェハによる代表値。試料の材質、熱容量により変動します。
*2 標準的なSiウェハによる代表値。試料の材質、熱容量により変動します。また物理的冷却速度に制限されます。
*3 装置寸法・重量には、周辺機器は含まれておりません。
| 項目 | 装置側接続形状 | 用力 |
|---|---|---|
| 電源(本体用) | M5端子台×3(RTS) 挿し込み式端子台×1(E) |
AC200V三相、50/60Hz、100A |
| 電源(パイロメータチラー用)* | 接地型2Pコンセント | AC100V、50/60Hz、5A |
| CDAまたはN2(冷却用) | 1/2”Swagelok | 0.3[MPa]、710~1133[L/min] ※3[um]のフィルタを通すこと |
| CDAまたはN2(アクチュエータ駆動用) | 1/4”Swagelok | 0.55[MPa]、30[L/min] |
| 冷却水 | 1/2”Swagelok (またはNPT3/8”) |
水温 15℃~35℃ 0.3~0.4[MPa]、13[L/min以上] ※100[um]のフィルタを通すこと ※DI水、蒸留水は使用不可 |
| プロセスガス | 1/4“VCR(Male) | 0.15[MPa]、10[slpm](標準) |
| キャビネット排気 | Φ101.6mm 短管 | 3000[slpm]以上 |
| ガスボックス排気 | Φ101.6mm 短管 | 3000[slpm]以上 |
| プロセス排気 | 1/2“Swagelok | - |
* ERPパイロメータオプションを選択した場合。
フォームが表示されるまでしばらくお待ち下さい。
恐れ入りますが、しばらくお待ちいただいてもフォームが表示されない場合は、こちらまでお問い合わせください。
PELCO® FlexScribe™は、試料表面にスクライブすることでウェハなどのサンプルを小片化するために最適なツールです。
常に真っ直ぐなスクライブを行うことができるスライド式スクライビング機構に取り付けられたスクライビングホイールを使用しています。
このツールは、スライドガラス、シリコン、III-V、サファイア、その他の結晶性で脆い材料など、形状に制限のないさまざまな材料のスクライブにご使用頂けます。
PELCO® FlexScribe™に取り付けられている標準の超硬タングステンカッターは、シリコン、ガラス、GaAs、その他の結晶性材料を含むさまざまなサンプルに最適です。
SiCなど硬度の高い材料向けには、ダイヤモンドのスクライビングホイールもオプションでご用意しております。
| 交換用スクライビングホイール | 超硬タングステン(標準)、ダイヤモンドの2種類 |
| 小サンプル用劈開ペンチ | 小さなサンプルの劈開に便利なペンチ FlexScribeによるスクライビング後の破断に最適 |
| 簡易劈開キット | 劈開ペンチ、ハンドダイヤモンドスクライブペンのセット |
フォームが表示されるまでしばらくお待ち下さい。
恐れ入りますが、しばらくお待ちいただいてもフォームが表示されない場合は、こちらまでお問い合わせください。
TDK株式会社様が
東京大学で開催されたナノ科学シンポジウム2024で
ポスター発表をし”審査員特別賞”を受賞致しました。
心よりお祝い申し上げます。
その発表内で、プローブ先端TEM観察用のサンプリング手法の開発で
WEST・BOND社製 モデル7200CR エポキシダイボンダー(高精度マニピュレーター)を
ご使用頂き100%に近い歩留まりを実現しております。
モデル7200CR エポキシダイボンダー
審査員特別賞を受賞された発表はこちら
ナノ科学シンポジウム2024_TDK株式会社様
製品に関するお問い合わせはこちら
~~~~~~~~~~~~~~~~~~
ハイソル株式会社 営業部
生稲(いくいね)
TEL:03-3836-2800
MAIL:ikuine@hisol.jp
~~~~~~~~~~~~~~~~~~