

スタンドアローン
8インチ対応 真空RTAシステム
AccuThermoシリーズ高速熱処理装置は、強力な可視~赤外光照射により、最大1250℃、昇温速度100℃/secでウェハの加熱処理を行う赤外線ランプアニール装置(RTP・RTAシステム)です。
AccuThermo AW820Vは真空中または任意のプロセスガス雰囲気で、最大8インチウェハ、または2インチウェハ×16枚、3インチウェハ×5枚、4インチウェハ×4枚のアニール処理に対応可能な真空RTP・RTAシステムです。
研究開発・試作用途のほか、小ロット生産にも対応可能な高性能・高信頼性ランプアニールシステムです。
 |
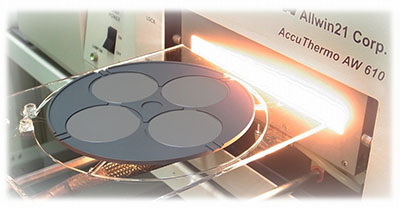 |
 |
| Si デバイス | 化合物半導体 | PVセル |
|---|
アプリケーション
- イオン注入後の活性化処理
- オーミックコンタクト形成
- GaAs, GaN, InP, SiC 等 化合物半導体のアニール
- PZT、SBT等 強誘電体薄膜の結晶化アニール
- PVセルのアニール
- 酸化膜生成
- シリサイド形成,サリサイド形成
- Polyシリコンのアニール処理
特長
- 真空プロセスに対応(到達真空度 0.01Pa※ターボ分子ポンプ使用時)
- スロットルバルブ制御による真空度調圧制御に対応。
- 最高到達温度 1250℃、最高昇温速度 150℃/秒の高速熱処理に対応。※標準的なSiウェハ処理時
- ランプゾーン出力制御(10ゾーン)による均熱性の向上(Δ10℃以内)
- 非接触加熱、コールドウォール構造によるクリーン熱処理。
- MFCによるプロセスガス流量制御(プログラマブル、最大5系統のMFCを組み込み可能)
- RTAプロセスに最適化された温度制御アルゴリズム。
- 組み込みPCによるレシピ編集/保存、リアルタイムプロセスモニター、プロセスデータ管理。
- ソフトウェア上でパイロメータキャリブレーションをはじめ各種キャリブレーションに対応。
- ウォッチドッグタイマー、過昇温防止、冷却水循環流量監視 等の徹底された安全対策。
真空チャンバー・加熱モジュールデザイン

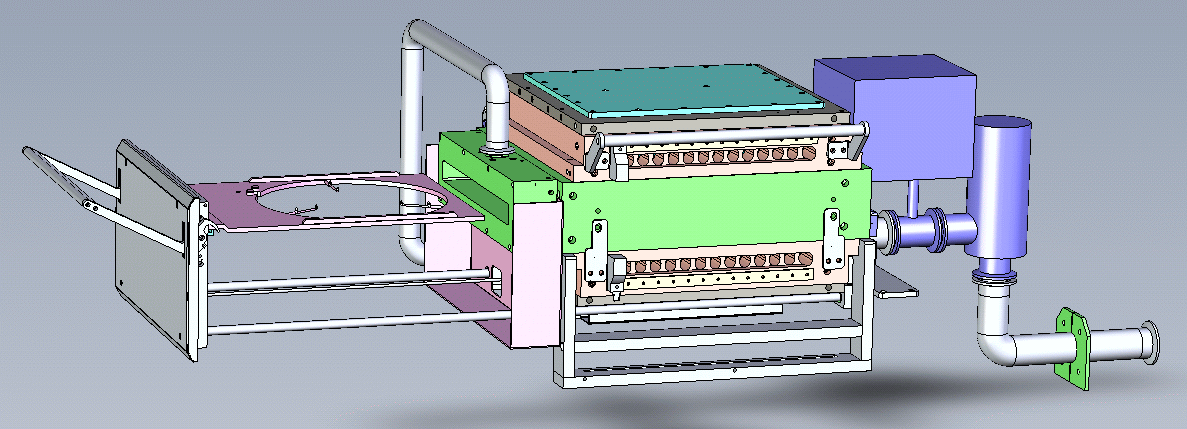
RTAProソフトウェア
AccuThermoシリーズRTAシステムには組み込みボードPCおよびRTAProソフトウェアが標準搭載されており、グラフィカルなインターフェイス上で任意のアニールレシピの作成・保存・実行、および プロセスデータの管理を行うことができます。また、ソフトウェア上で熱電対回路やパイロメータ、チャンバー/ランプ等のキャリブレーションを容易に行うことができ、安定かつ再現性の高いアニールプロセスを実行できます。
仕様
| 項目 | 仕様 |
|---|---|
| 対応基板サイズ | [標準] φ5インチ ~ φ8インチ [オプション] φ2インチ ~ φ4インチ [オプション] 200mm × 200mm 角型基板 [オプション] サセプタ使用時:個片チップ~φ8インチ |
| 到達真空度 | 0.01Pa(*1) |
| 真空度調圧範囲(オプション) | 6.7Pa ~ 1733Pa,大気圧 |
| 温度制御範囲 | 100℃ ~ 1250℃ |
| 加熱方式 | 赤外線ランプ放射加熱(1.5kW×27本,Top 13、Bottom 14) |
| 冷却方式 | ガスパージによる強制空冷 |
| 加熱方向 | 上下面2方向 |
| 温度制御方式 | 検出温度フィードバックによるクローズドループ制御 |
| 昇温速度 | 10℃/sec ~ 100℃/sec(*2) |
| 降温速度 | 10℃/sec ~ 100℃/sec(*3) |
| 温度測定精度 | ±1℃(校正後) |
| 面内温度均一性 | ΔT 10℃(*2) |
| ランプゾーン数 | 10ゾーン独立制御 |
| 試料ローディング方式 | フロントローディング(手動) |
| プロセス処理室、試料搭載部 | 上下面石英ウィンドウ付 アルミニウムチャンバー、石英トレイ |
| チャンバー冷却方式 | 空冷・水冷併用 |
| プロセスガス種 | N2、O2、He、Ar、フォーミングガス(水素濃度5%程度) その他のガス種はご相談ください |
| プロセスガス系統数 | [標準] 1系統(N2) [オプション] 最大5系統 |
| プロセスガス流量制御範囲 | [標準] 0.2slpm ~ 10slpm (MFCによる制御) [オプション] 20sccm ~ 1000sccm (MFCによる制御) 他 |
| 登録レシピ数 | 制限なし |
| レシピ当たりのステップ数 | 最大40ステップ (サイクリックアニールの場合、最大99ループ対応) |
| プロセス制御方式 | 装置組み込みコンピューターボード、RTAProソフトウェア、17インチタッチスクリーン、キーボード、マウス |
| ソフトウェアの主な機能 | リアルタイムプロセスモニタ レシピ編集、保存、読み出し プロセスデータリコール プロセスデータ出力(Txt形式) 各種キャリブレーション システム診断 etc. |
| 安全対策 | 非常停止SW、過昇温検出、冷却水監視、ドア開閉監視、ウォッチドッグタイマー etc. |
| 外形寸法・重量 | W978 × D1220 × H1780 mm・460kg(*4) |
*1 適切な真空ポンプを接続した場合。
*2 標準的なSiウェハによる代表値。試料の材質、熱容量により変動します。
*3 標準的なSiウェハによる代表値。試料の材質、熱容量により変動します。また物理的冷却速度に制限されます。
*4 装置寸法・重量には、周辺機器は含まれておりません。
ユーティリティ
| 項目 | 装置側接続形状 | 用力 |
|---|---|---|
| 電源(本体用) | M5端子台×3(RTS) 挿し込み式端子台×1(E) |
AC200V三相、50/60Hz、100A |
| 電源(真空ポンプ用) | - | 真空ポンプの仕様による |
| CDAまたはN2(冷却用) | 1/2”Swagelok | 0.3[MPa]、710~1133[L/min] ※3[um]のフィルタを通すこと |
| CDAまたはN2(アクチュエータ駆動用) | 1/4”Swagelok | 0.55[MPa]、30[L/min] |
| 冷却水 | 1/2”Swagelok (またはNPT3/8”) |
水温 15℃~35℃ 0.3~0.4[MPa]、13[L/min以上] ※100[um]のフィルタを通すこと ※DI水、蒸留水は使用不可 |
| プロセスガス | 1/4“VCR(Male) | 0.15[MPa]、10[slpm](標準) |
| 真空 | NW25 | 真空仕様による |
| キャビネット排気 | Φ101.6mm 短管 | 3000[slpm]以上 |
| ガスボックス排気 | Φ101.6mm 短管 | 3000[slpm]以上 |
| プロセス排気 | 1/2“Swagelok | - |
オプション
- 真空ポンプ(ドライポンプ、ターボ分子ポンプ)
- 真空度モニタ、調圧機能
- 大気圧プロセス対応
- プロセスガスライン(MFC)追加:最大5系統
- 各種サセプタ(SiCコーティンググラファイト,SiCコーティングシリカ)
- 各種Siキャリア(Siインゴット)
- 低酸素濃度プロセス用 2重Oリング
- 低酸素濃度プロセス用 残留酸素濃度測定器
- スペアパーツキット Level 1,Level 2,Level 3
- GEM/SECSⅡ ネットワーク機能
お問い合わせ
フォームが表示されるまでしばらくお待ち下さい。
恐れ入りますが、しばらくお待ちいただいてもフォームが表示されない場合は、こちらまでお問い合わせください。
個人情報保護方針(プライバシーポリシー)
- 個人情報に関する法令・規範を遵守します。
- 当社はお客様の個人情報への不正アクセス、紛失、破壊、改ざん及び漏洩等の防止に努めます。
- 個人情報は法令に基づき開示される以外は、個人情報をお客様に明示した利用目的の範囲内で取扱い、第三者に譲渡、提供はしません。
- 当社は個人情報保護に対する取組みを継続的に見直し、適宜改善します。