

低圧環境下でプラズマを用いたストリッピング・デスカムを行うシステムです。
従来のウェットエッチング方式と比較して薬液を使用しないプロセスの為
安全性が高く、マニュアルロードのCV200RFSはR&D、少量生産用途に
最適です。タッチパネルによる簡便な操作で、最適な処理条件を設定できます。
アプリケーション
- フォトレジスト除去
- 有機物除去
- 表面改質
- コンタミ(フラックス等)の除去
- ポリイミド除去
- エッチング
- デスカム レジスト残渣除去
装置特長
- チャンバー内のホットプレート上でプラズマ処理。正確な温度制御によりストリップレートをコントロールし、また、熱に弱いワークも処理可能。
- 任意のガス4種を選択可能、オプションのマスフローコントローラで
CPUによるガス混合、流量コントロールが可能 - 最大12種のクリーニング条件をメモリーし、
フロントパネルの操作で容易にプログラム設定 - プラズマ出力は100~1000Wまで設定可能。
クリーニング対象に応じてストリップ/ディスカム用途から表面改質用途まで幅広く使用することができます - 薄膜基板上の酸化ニッケル、水酸化ニッケル等の無機質汚染も確実に除去
- ストリップレートは、最大7,000Å/分
チャンバーデザイン
電極から発生したプラズマは、穴が開いたグラウンドプレートを通り、ワーク表面へ到達します。これによりプラズマ中の電子(-)を取り除き、ワークへのダメージを最小限に防ぐことができます。
CMOSデバイスなどは、電子によるダメージがCV特性のずれの原因となります。
CV200RFSのプラズマ処理により起こるCV特性のずれは、実質ゼロです。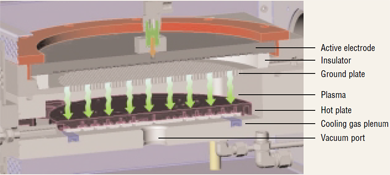
CMOSデバイスなどは、電子によるダメージがCV特性のずれの原因となります。
CV200RFSのプラズマ処理により起こるCV特性のずれは、実質ゼロです。
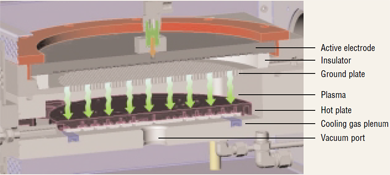
CV200RFS チャンバー内部構造
熱ダメージを最小化
 CV200RFSでは、プラズマ照射中のワークの温度はワークを載せるホットプレートにより高精度に制御されます。
CV200RFSでは、プラズマ照射中のワークの温度はワークを載せるホットプレートにより高精度に制御されます。
また、ワークの耐熱性に応じてプロセス中の温度リミットを設定することができ、プロセス中にワーク温度が設定値に達するとプラズマはOFFになります。
従ってワークに設定値以上の熱負荷がかかることはありません。
この機能により、熱には弱いが長時間プラズマを照射する必要がある、ポリイミドのストリップやイオン注入されたフォトレジストのストリップ等の要求にも応えることができます。
仕様
| 製品名 | CV200RFS |
|---|---|
| クリーン度 | Class 10 |
| 動作温度 | 常温 – 250 ℃ |
| 温度安定性 | < 10% |
| 冷却方式 | 強制空冷 |
| チャンバーサイズ (約) W × D × H |
25 × 29 × 5 cm |
| 本体サイズ (約) W × D × H |
61 × 109 × 114 cm |
| 重量 | 147 kg |
| キャパシティ | シングル 50 – 200mmウェハ ダブル 100mmウェハ |
| N2フローレート | 最大 1.7 SCFM |
| プロセスガスフローレート | 20 – 50 SCCM |
| プロセスガス | 4種 |
| マスフローコントローラ | オプション 最大4個 |
| ホットプレートエリア | 最大 200mm ウェハ |
| レシピ数 | 12レシピ |
| スループット | 1 ウェハ / 分 |
| ストリップレート | 最大 7,000Å / 分 |
| プラズマ照射時間 | 0 – 1,200 秒 |
| 設定分解能 | 1 秒 |
| RFプラズマ | 40kHz, 100 – 1,000W |
| 電源 | 単相 200 – 250V, 20A, 50/60Hz |
お問い合わせ
フォームが表示されるまでしばらくお待ち下さい。
恐れ入りますが、しばらくお待ちいただいてもフォームが表示されない場合は、こちらまでお問い合わせください。
個人情報保護方針(プライバシーポリシー)
- 個人情報に関する法令・規範を遵守します。
- 当社はお客様の個人情報への不正アクセス、紛失、破壊、改ざん及び漏洩等の防止に努めます。
- 個人情報は法令に基づき開示される以外は、個人情報をお客様に明示した利用目的の範囲内で取扱い、第三者に譲渡、提供はしません。
- 当社は個人情報保護に対する取組みを継続的に見直し、適宜改善します。