各種お問い合わせやカタログ・資料のご請求などにはこちらのフォームがご利用いただけます。
必要項目をご記入の上、お送り下さい。
レーザー微細加工装置
豊富な加工事例、メカトロ設計技術、精密位置決め技術、ソフトウェア開発技術の組み合わせにより、お客様のレーザー薄膜加工アプリケーションに、最適なシステムをご提供できます。
- レーザー発振器およびレーザー加工用顕微鏡のコーディネート
- JIS-C6802 クラス1準拠の安全対策筐体の製作
- 精密ステージ (手動 / 電動 / セミオート) の製作
- 制御ソフトウェアの制作
- HOYA社 HSLシリーズの代替製品をご提案可能です
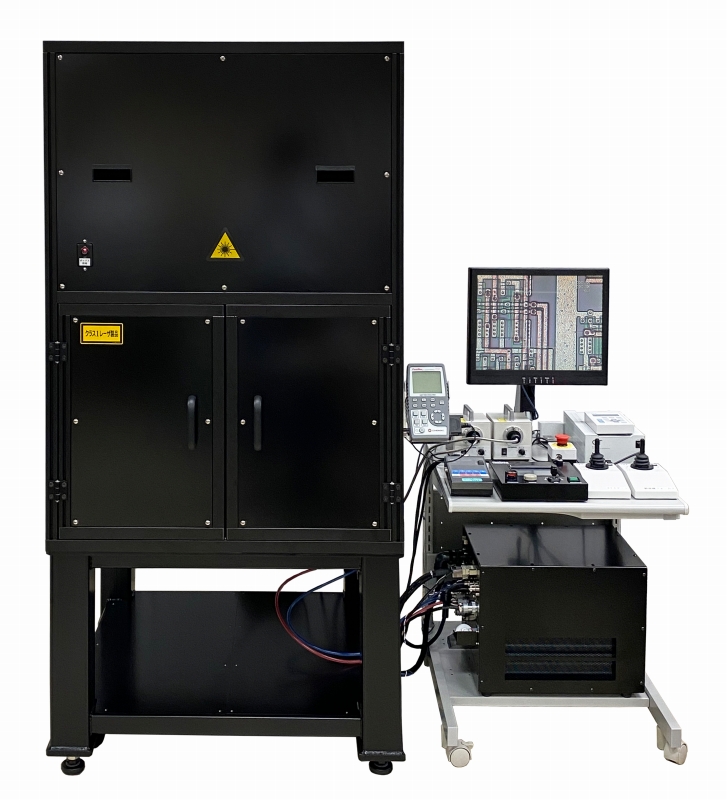
特長

- 大気圧下での加工
- レーザー加工サイズ 1um~300um□で調節可
- 多波長 (1064,532,355,266nm) 対応のため、多彩な材質をカッティング可能
- リアルタイム加工 (顕微鏡で加工状態を観察しながら加工可能)
- JIS-C6802 クラス1レーザー安全対策
- メンテナンスが容易
用途
- FIB、SEM前のポイントマーキング
- ICの保護膜、層間膜の除去
- ICのメタル配線のカット
- 有機デバイス等のパターンニング
- 液晶ディスプレイ、カラーフィルタのリペア
- 薄膜、厚膜パターンのショート欠陥リペア
- 高周波キャパシタのトリミング
- LSIの欠陥救済用ヒューズカット etc.
システム構築例
ラボ用の小型、手動ステージモデルから、オートフォーカスやパターン認識を組み込んだ生産用セミオートモデル、故障解析に特化した微細マーキングモデル等、設計製作にて対応します。
各種マニュアルプローバーやセミオートプローバーにレーザーを搭載することも可能です。
 簡易カバータイプ(クラス4),100mm□手動ステージ |
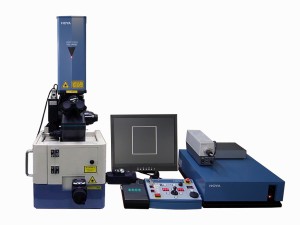 卓上小型タイプ(クラス1),100mm□手動ステージ |
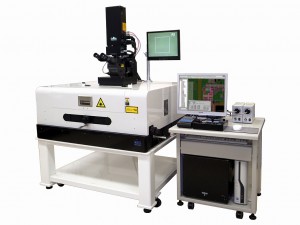 大型基板対応,500mm□手動ステージ |
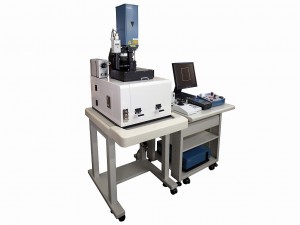 3インチφウェハ対応電動ステージモデル |
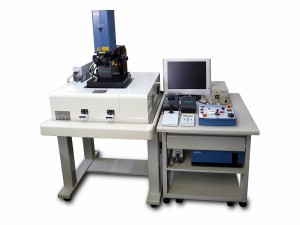 8インチφウェハ対応電動ステージモデル |
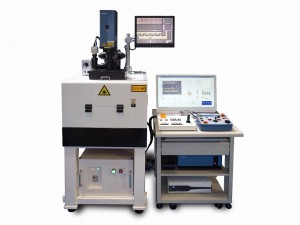 故障解析用セミオートマーキングモデル |
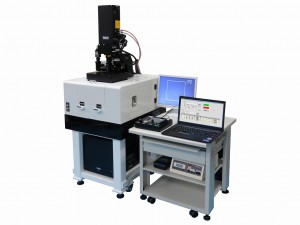 薄膜自動パターニングシステム |
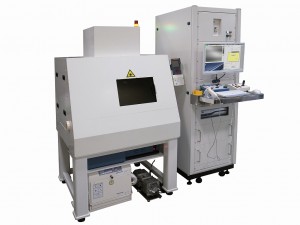 生産用セミオートリペアシステム |
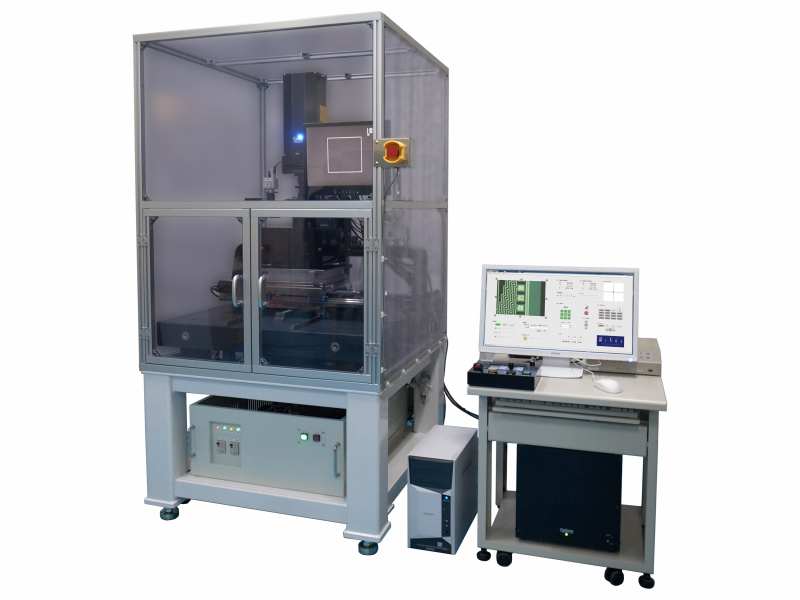 大型基板対応セミオートシステム |
 レーザー搭載マニュアルプローバー |
レーザー発振波長と加工対象材質
加工対象材質に合わせて、レーザー発振波長を4波長から選択できます。(1波長~最大4波長)
・ 1064nm,532nm 熱加工
・ 355nm,266nm アブレーション加工
【レーザー発振波長による加工適合性】 ※参考
| 1064nm(IR) | 532nm(Green) | 355nm(UV) | 266nm(DUV) |
|---|---|---|---|
| アルミ(Al) クロム(Cr) ニッケル(Ni) ITO |
アルミ(Al) クロム(Cr) ニッケル(Ni) チタン(Ti) 金(Au) 銅(Cu) ポリシリコン ITO |
アルミ(Al) クロム(Cr) モリブデン(Mo) シリコン(Si) ポリイミド 窒化膜 シリコン酸化膜(SiO2) ITO |
アルミ(Al) クロム(Cr) モリブデン(Mo) シリコン(Si) シリコンカーバイト(SiC) ポリイミド 窒化膜 シリコン酸化膜(SiO2) ITO |
システム要素技術
ハードウェア
| 項目 | 仕様 |
|---|---|
| レーザー発振器 波長 | 1064nm/532nm/355nm/266nm |
| レーザー最大出力エネルギー | ~12mJ ※発振器モデル、選択レーザー波長による |
| レーザー発振周波数 | 30Hz/60Hz |
| レーザー加工サイズ | <1um□ ~ 300um□ ※選択レーザー波長、対物レンズ構成による |
| ステージ方式 | マニュアル / 自動 |
| ステージ移動量 | 100mm□ ~ 500mm□ ※500mm□以上は要ご相談 |
| ステージ制御軸数 | XYZθ 4軸(標準) |
| ステージ位置決め精度 | XY <±5um(標準) XY <±1um(オプション) ※セミオートモデル、ステージ移動量により変動します |
| 顕微鏡照明 | 同軸落射(標準) 透過照明/拡散照明/暗視野(オプション) |
| オートフォーカス | 追従型AF,コントラストAF(オプション) |
| 除振システム | パッシブ / アクティブ(オプション) |
| 抵抗測定 – 自動トリミング | 対応可 ※要ご相談 |
| ローダー・アンローダー対応 | 対応可 ※要ご相談 |
| 安全対策 | JIS-C6802 [レーザー製品の放射安全基準] に準拠 |
ソフトウェア
- レーザー加工条件設定
- 位置決めステージ自動制御
- 画像認識(パターンマッチング)によるオートアライメント、位置補正 ※
- 画像認識による合否判定 ※
- 自動パターンニング ※
- CADナビゲーション(DXF/GDSII/Gerber etc.) ※
- ※要ご相談

お問い合わせ
フォームが表示されるまでしばらくお待ち下さい。
恐れ入りますが、しばらくお待ちいただいてもフォームが表示されない場合は、こちらまでお問い合わせください。
個人情報保護方針(プライバシーポリシー)
- 個人情報に関する法令・規範を遵守します。
- 当社はお客様の個人情報への不正アクセス、紛失、破壊、改ざん及び漏洩等の防止に努めます。
- 個人情報は法令に基づき開示される以外は、個人情報をお客様に明示した利用目的の範囲内で取扱い、第三者に譲渡、提供はしません。
- 当社は個人情報保護に対する取組みを継続的に見直し、適宜改善します。
エリプソメーター
自動偏光解析装置 世界最小エリプソメーター


エリプソメーターとは、光を試料に照射し、試料から反射される光の偏光状態の変化を測定し、薄膜の厚さ、屈折率や吸収係数などの光学定数、あるいは、バルク材の光学定数を解析する装置です。
非接触・非破壊かつ高精度の測定が行えるための各方面で使用されています。
仕様例
| 測定方法 | 回転位相子法(RQ法) |
|---|---|
| 光源 | 0.8mw He-Neレーザー (λ/632.8nm) |
| ビーム径 | 0.8mmФ |
| 入射角 | 固定(通常70度) |
| サンプルステージ | 自動 θ-Yステージ 標準にて Ф160mmまで(全面自動測定可) モータドライブ Z軸 手動チルト機構付き |
| 測定精度 | △/±0.01°ψ/±0.01°[但しSiO2(1000Å)/Si 測定時] |
| 測定時間 | Min0.05秒(通常2秒) |
| コントロールステーション | Dos/V パソコン |
| 寸法 | 300×400×450(本体) |
| 他に、制御ユニット・パソコン類 | |
| * サンプルステージの仕様はご相談に応じます。 | |
ラインナップ
| タイプ | 入射角 | サンプルステージ |
|---|---|---|
| タイプ1 | 固定 | 固定 |
| タイプ2 | 固定 | 手動 θ-Y |
| タイプ3 | 固定 | 自動 θ-Y |
| タイプ4 | 手動可変 | 固定 |
| タイプ5 | 手動可変 | 手動 θ-Y |
| タイプ6 | 手動可変 | 自動 θ-Y |
| タイプ7 | 手動可変 | 固定 |
| タイプ8 | 手動可変 | 手動 θ-Y |
| タイプ9 | 手動可変 | 自動 θ-Y |
- 入射角固定
通常70度にて固定します。 - 入射角手動可変
50・60・70・80度の手動可変になります。 - 入射角自動可変
45~90度 0.01度ステップで設定が可能です。
5入射まで自動で測定を行えます。 - 固定サンプルステージ
サンプルの1点を測定するためのステージです。
手動チルト・手動高さ調整機付き - 手動サンプルステージ
手動のθ-Yステージにて測定場所を決定します。
手動θ軸 ストローク:360度 目盛り無し
手動Y軸 ストローク:75mm マイクロメータ
ヘッド取り付け可能 - 自動サンプルステージ
自動のθ-Yステージにて自動多点測定が可能です。
マッピング測定も可能で、結果を3次元鳥瞰図にて表示も可能です。
自動θ軸 ストローク:360度 分解能:0.1度
自動Y軸 ストローク:75mm 分解能:0.1mm
お問い合わせ
フォームが表示されるまでしばらくお待ち下さい。
恐れ入りますが、しばらくお待ちいただいてもフォームが表示されない場合は、こちらまでお問い合わせください。
個人情報保護方針(プライバシーポリシー)
- 個人情報に関する法令・規範を遵守します。
- 当社はお客様の個人情報への不正アクセス、紛失、破壊、改ざん及び漏洩等の防止に努めます。
- 個人情報は法令に基づき開示される以外は、個人情報をお客様に明示した利用目的の範囲内で取扱い、第三者に譲渡、提供はしません。
- 当社は個人情報保護に対する取組みを継続的に見直し、適宜改善します。
コレット&各種ツール
コレット

チップを2辺で吸着します。

チップを4辺で吸着します。

チップ表面を吸着します。
先端形状

コレットはすべてカスタム品となります。
材質
- タングステンカーバイト
- デルリン
- ベスペル
各種ツール
各種T.A.B(タブ)ツール
- シングルポイントTAB
- ダブルクロスグルーブシングルTAB
- 円形突起シングルポイントTAB
- V型シングルポイントTAB
材質
- チタンカーバイト材
- サーメットチップ(セラミックと金属の複合材)
- 先端ダイヤモンド材
アンプラギングプローブ

金線が詰まったときに、キャピラリーをボンダーから取り外し先端部の詰まりを取る針です。
・お気軽にお問い合わせ下さい、最適な製品をご提供致します。
お問い合わせ
フォームが表示されるまでしばらくお待ち下さい。
恐れ入りますが、しばらくお待ちいただいてもフォームが表示されない場合は、こちらまでお問い合わせください。
個人情報保護方針(プライバシーポリシー)
- 個人情報に関する法令・規範を遵守します。
- 当社はお客様の個人情報への不正アクセス、紛失、破壊、改ざん及び漏洩等の防止に努めます。
- 個人情報は法令に基づき開示される以外は、個人情報をお客様に明示した利用目的の範囲内で取扱い、第三者に譲渡、提供はしません。
- 当社は個人情報保護に対する取組みを継続的に見直し、適宜改善します。
ウエッジボンディング用ウエッジツール
ウエッジボンディング用ウエッジツール
ラインナップ
・スタンダードウエッジ
フィード角30度、45度、60度の3種類を取り揃えております。
・太線用ウエッジ
太線(76μm~508μm)のボンディング用のウエッジです。
・リボン線用ウエッジ
・ファインピッチ用ウエッジ
パッドピッチが50μm~150μm対応のウエッジです。
・金線用ウエッジ
超音波を効率よく伝えるためにボンド面中央部にクロスグルーブが付いています。
・ディープアクセス(深打ち)ウエッジ
高い側壁によりボンディングできなかった場所用に開発されたウエッジです。
・特別仕様
先端仕上げ、形状等カスタムメイドが可能です。
- 材質
- タングステンカーバイト材
- チタンカーバイト材
- サーメットチップ(セラミックと金属の複合材)
* 尚、詳細につきましては別途お問合せ下さい。
お問い合わせ
フォームが表示されるまでしばらくお待ち下さい。
恐れ入りますが、しばらくお待ちいただいてもフォームが表示されない場合は、こちらまでお問い合わせください。
個人情報保護方針(プライバシーポリシー)
- 個人情報に関する法令・規範を遵守します。
- 当社はお客様の個人情報への不正アクセス、紛失、破壊、改ざん及び漏洩等の防止に努めます。
- 個人情報は法令に基づき開示される以外は、個人情報をお客様に明示した利用目的の範囲内で取扱い、第三者に譲渡、提供はしません。
- 当社は個人情報保護に対する取組みを継続的に見直し、適宜改善します。
ボールボンディング用キャピラリー
ラインナップ
・スタンダードキャピラリー
アルミナセラミック製のキャピラリーです。
・特注キャピラリー
先端形状からツールの材質まですべてカスタムメイドのキャピラリーです。
・ボールバンプ用キャピラリー
バンプボンディング専用のキャピラリーです。
ご希望のボールサイズによって作製される特注キャピラリーです。
・スモールボール用キャピラリー
小ボール狭ピッチ対応のキャピラリーです。
ワイヤーボンディング・バンプボンディングの両方に対応しています。
・ファインピッチ向けキャピラリー(ボトルネックキャピラリー)
パッドピッチが50μm~100μm対応のボトルネックキャピラリーです。
・超ファインピッチボールボンディング用キャピラリー
パッドピッチが50μm以下に対応のボトルネックキャピラリーです。
・材質
- アルミナセラミック
- ジルコニア強化セラミック
- タングステンカーバイト
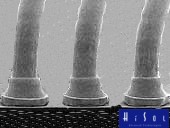


* お気軽にお問い合わせください、最適なキャピラリーをご提供致します。
お問い合わせ
フォームが表示されるまでしばらくお待ち下さい。
恐れ入りますが、しばらくお待ちいただいてもフォームが表示されない場合は、こちらまでお問い合わせください。
個人情報保護方針(プライバシーポリシー)
- 個人情報に関する法令・規範を遵守します。
- 当社はお客様の個人情報への不正アクセス、紛失、破壊、改ざん及び漏洩等の防止に努めます。
- 個人情報は法令に基づき開示される以外は、個人情報をお客様に明示した利用目的の範囲内で取扱い、第三者に譲渡、提供はしません。
- 当社は個人情報保護に対する取組みを継続的に見直し、適宜改善します。
窒素ガス&ドライエアー発生装置
窒素ガス発生装置
| 防爆用 | タンク、反応槽、蒸留槽、配管などのパージ、保安用、可燃物・爆発物のシール、キャリアーガス |
|---|---|
| 分析機器用 | LC/MS、FTIR |
| 無酸化防湿保存用 | 薬品・食品・インク類無酸化シールガス、食品包装等の充填ガス |
| 熱処理時の酸化防止用 | 雰囲気ガス、はんだ付時酸化防止 |
| 樹脂成形用 | |
| 半田槽、リフロー炉用 |
膜分離式窒素発生装置

コンプレッサ内蔵型 【PNU-02IT20F】
- 窒素濃度 95~99.9%まで自由に変更可能
- メンテナンスが簡単
- クリーンルーム仕様対応可能
- 装置作動音が静か 〈60db以下〉
コンプレッサ無し 【PNG2-02BD】
- 窒素濃度 95~99.9%まで自由に変更可能
- メンテナンスが簡単
- コンパクト設計・軽量
- クリーンエアー
その他


- 各種コンプレッサ
- タンクユニット
- バキュームユニット

お問い合わせ
フォームが表示されるまでしばらくお待ち下さい。
恐れ入りますが、しばらくお待ちいただいてもフォームが表示されない場合は、こちらまでお問い合わせください。
個人情報保護方針(プライバシーポリシー)
- 個人情報に関する法令・規範を遵守します。
- 当社はお客様の個人情報への不正アクセス、紛失、破壊、改ざん及び漏洩等の防止に努めます。
- 個人情報は法令に基づき開示される以外は、個人情報をお客様に明示した利用目的の範囲内で取扱い、第三者に譲渡、提供はしません。
- 当社は個人情報保護に対する取組みを継続的に見直し、適宜改善します。
ダイシング添加剤
ダイシング添加剤 ディアマフロー
世界トップシェアのKETECA社のダイシング添加剤ディアマフロー。
ダイシング時の切削水に添加することで、
ウエハのチッピングやクラックを低減、
パッドの腐食、再付着の防止につながります。
歩留まりアップ、ブレードライフの向上、コスト削減に。
概要

- ダイシングプロセス時に添加することで、製品の歩留まり向上。
- 製品は親水性・親油性であり、切削水の表面張力を低減。
- 切削水の表面張は50パーセント以上低下します。
(表面張力:72→31 dynes/cmに低下) - 切り口の深くまで切削水が浸漬し、切削箇所が低温に保たれます。
- 生分解性物質、排水処理も簡易です。RoHS2認証を取得。
特徴
- ダイシング切削水の表面張力を低減し、ブレードとウエハ間に深く浸透し冷却水の効果を向上。
- 取り扱いが簡易で、様々なダイシングメーカーの装置に対応可能。
- KETECA社のディスペンサーシステムを使用し、純水とディアマフローの安定した比率で供給。
- 濡れ性の向上とパーティクル除去率の向上へ。ダイシング後のダイやボンディングパッドをよりクリーンな状態に。
ダイシング添加剤有無の比較
水分子は高い表面張力の為、ウエハの上部に溜まり、切り口に浸透しにくいです。
その為、ブレードと切削領域に切りくずが蓄積し、チッピング、内部クラックが生じやすいです。
ディアマフローを使用することによって、表面張力を効果的に低下させ、切り口に奥深くまで水が浸透し、切削くずが流出し、切削部分が低温に保たれます。
KETECA社自動供給システム
ディアマフローを添加する際、純水と一定の割合で、ダイシング装置に供給する必要があります。
使用されるダイシング装置の数に合わせて、ダイシング添加剤を自動供給に最適な装置をご提案させて頂きます。
お問い合わせ
フォームが表示されるまでしばらくお待ち下さい。
恐れ入りますが、しばらくお待ちいただいてもフォームが表示されない場合は、こちらまでお問い合わせください。
個人情報保護方針(プライバシーポリシー)
- 個人情報に関する法令・規範を遵守します。
- 当社はお客様の個人情報への不正アクセス、紛失、破壊、改ざん及び漏洩等の防止に努めます。
- 個人情報は法令に基づき開示される以外は、個人情報をお客様に明示した利用目的の範囲内で取扱い、第三者に譲渡、提供はしません。
- 当社は個人情報保護に対する取組みを継続的に見直し、適宜改善します。
卓上型シランCVD成膜装置


プラズマ洗浄~ワーク脱水(デハイドレーション)~シランCVD~ガス排出まで
チャンバー内で自動一括処理できる、R&D向けの卓上型シランCVD装置です。
無機物と有機物の接着に有効なSAM膜(自己組織化単分子膜)を基板上に形成します。
ワークの温度、蒸気温度、蒸気圧及びCVD処理時間な、どプロセス中の全てのパラメータを
コントロールすることができ、様々なアプリケーションに対して最適な表面処理の結果が得られます。
卓上小型で設置場所を問わずR&D、少量生産用途に最適なシステムです。
アプリケーション
- SAM膜(自己組織化単分子膜)の形成
- シランカップリング処理(有機物と無機物の化学的結合に有効)
- 表面改質処理(親水性・疎水性コントロール)
- スライドガラスへのシランコート
- ウェハのフォトレジスト接着性向上(HMDS処理)
- マイクロアレイ シランと基板の接着
- 摩擦ダメージ(スティクション)防止の為のMEMSコーティング
- バイオMEMSやバイオセンサのドリフト防止コーティング
- 金属材料の防食(さび止め)コーティング
- 生体適合性の向上 etc….
装置特長
- アミノシラン、エポキシシラン、メルカプトシラン、APTES, FDTS etc…
ご用途に応じた多様なシランカップリング剤を使用できます - ワークの温度、蒸気温度、蒸気圧及びCVD処理時間など
全てのパラメータをコントロールし、最適な表面処理結果が得られます - 高い温度安定性でムラの無い膜を形成
- チャンバー内で全行程自動一括処理される為、安全性が非常に高い
- ベーパープライム方式は、スピンコート方式と比較して薬液使用量を約99%削減、
MEMSなどの立体構造物も問題なく処理可能 - 205℃以下の低温プロセス蒸着による、高い汎用性
CVDプロセス前のプラズマ洗浄
EcoCoatでは、CVDプロセス前にプラズマ洗浄を行うことができます。
YES社のプラズマ洗浄プロセスは以下の特長があり、あらゆるワークに対応可能な装置となっています。
①40kHzの低周波数プラズマ
13.56MHzの高周波プラズマと比較して、熱損失が少なく効率の良いプラズマ処理。
(少ない電力消費で高い処理結果を実現)
②平行平板式のチャンバーデザイン
ワークの大きさ(高さ)に応じてトレイをレイアウト可能
電極の役割を果たすトレイ間で面内全体にプラズマが発生する為、
温度安定性が高く、再現性の高い処理結果を実現
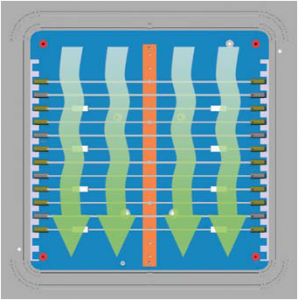
プラズマ洗浄中のチャンバー内部イメージ
Eco Coatのプロセスチャート(参考)
仕様
| 製品名 | EcoCoat |
|---|---|
| 適合クリーンルーム | Class 10 |
| チャンバーサイズ (約) W × D × H |
41 × 46 × 41 cm |
| 本体サイズ (約) W × D × H |
116 × 98 × 113 cm |
| キャパシティ (ウェハの場合、25枚/カセット) |
4″,6″ ウェハ 8カセット 8″ ウェハ 2カセット 12″ ウェハ 1カセット |
| キャパシティ (スライドの場合、別途トレイ&シェルフが必要) |
約2,000枚 |
| スループット | 1バッチ / 時 (設定するレシピにより異なります) |
| 動作温度 | 常温 – 205℃ |
| 温度安定性 | ± 5℃ |
| 薬品数(フラスク数) | 2個 (オプション 最大3個) |
| 薬品使用量 | 0.1 – 3 ml |
| マスフローコントローラ | オプション 最大3個 |
| レシピ数 | CVD : 6 レシピ プラズマ : 4 レシピ |
| プロセス時間 | 1 – 999,999 秒 |
| 時間設定分解能 | 1 秒 |
| RFプラズマ周波数 | 40kHz |
| RFプラズマパワー | 100 -1000 W |
| プラズマガス入力ポート | 3個 |
| プロセスガス入力ポート | 1個 |
| 電源 | 単相 208V, 30A, 60Hz |
お問い合わせ
フォームが表示されるまでしばらくお待ち下さい。
恐れ入りますが、しばらくお待ちいただいてもフォームが表示されない場合は、こちらまでお問い合わせください。
個人情報保護方針(プライバシーポリシー)
- 個人情報に関する法令・規範を遵守します。
- 当社はお客様の個人情報への不正アクセス、紛失、破壊、改ざん及び漏洩等の防止に努めます。
- 個人情報は法令に基づき開示される以外は、個人情報をお客様に明示した利用目的の範囲内で取扱い、第三者に譲渡、提供はしません。
- 当社は個人情報保護に対する取組みを継続的に見直し、適宜改善します。
プラズマストリッパー・デスカム装置


低圧環境下でプラズマを用いたストリッピング・デスカムを行うシステムです。
従来のウェットエッチング方式と比較して薬液を使用しないプロセスの為
安全性が高く、マニュアルロードのCV200RFSはR&D、少量生産用途に
最適です。タッチパネルによる簡便な操作で、最適な処理条件を設定できます。
アプリケーション
- フォトレジスト除去
- 有機物除去
- 表面改質
- コンタミ(フラックス等)の除去
- ポリイミド除去
- エッチング
- デスカム レジスト残渣除去
装置特長
- チャンバー内のホットプレート上でプラズマ処理。正確な温度制御によりストリップレートをコントロールし、また、熱に弱いワークも処理可能。
- 任意のガス4種を選択可能、オプションのマスフローコントローラで
CPUによるガス混合、流量コントロールが可能 - 最大12種のクリーニング条件をメモリーし、
フロントパネルの操作で容易にプログラム設定 - プラズマ出力は100~1000Wまで設定可能。
クリーニング対象に応じてストリップ/ディスカム用途から表面改質用途まで幅広く使用することができます - 薄膜基板上の酸化ニッケル、水酸化ニッケル等の無機質汚染も確実に除去
- ストリップレートは、最大7,000Å/分
チャンバーデザイン
CMOSデバイスなどは、電子によるダメージがCV特性のずれの原因となります。
CV200RFSのプラズマ処理により起こるCV特性のずれは、実質ゼロです。
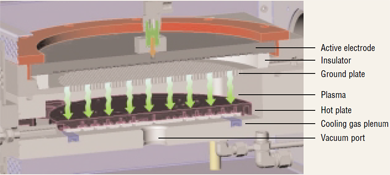
CV200RFS チャンバー内部構造
熱ダメージを最小化
 CV200RFSでは、プラズマ照射中のワークの温度はワークを載せるホットプレートにより高精度に制御されます。
CV200RFSでは、プラズマ照射中のワークの温度はワークを載せるホットプレートにより高精度に制御されます。
また、ワークの耐熱性に応じてプロセス中の温度リミットを設定することができ、プロセス中にワーク温度が設定値に達するとプラズマはOFFになります。
従ってワークに設定値以上の熱負荷がかかることはありません。
この機能により、熱には弱いが長時間プラズマを照射する必要がある、ポリイミドのストリップやイオン注入されたフォトレジストのストリップ等の要求にも応えることができます。
仕様
| 製品名 | CV200RFS |
|---|---|
| クリーン度 | Class 10 |
| 動作温度 | 常温 – 250 ℃ |
| 温度安定性 | < 10% |
| 冷却方式 | 強制空冷 |
| チャンバーサイズ (約) W × D × H |
25 × 29 × 5 cm |
| 本体サイズ (約) W × D × H |
61 × 109 × 114 cm |
| 重量 | 147 kg |
| キャパシティ | シングル 50 – 200mmウェハ ダブル 100mmウェハ |
| N2フローレート | 最大 1.7 SCFM |
| プロセスガスフローレート | 20 – 50 SCCM |
| プロセスガス | 4種 |
| マスフローコントローラ | オプション 最大4個 |
| ホットプレートエリア | 最大 200mm ウェハ |
| レシピ数 | 12レシピ |
| スループット | 1 ウェハ / 分 |
| ストリップレート | 最大 7,000Å / 分 |
| プラズマ照射時間 | 0 – 1,200 秒 |
| 設定分解能 | 1 秒 |
| RFプラズマ | 40kHz, 100 – 1,000W |
| 電源 | 単相 200 – 250V, 20A, 50/60Hz |
お問い合わせ
フォームが表示されるまでしばらくお待ち下さい。
恐れ入りますが、しばらくお待ちいただいてもフォームが表示されない場合は、こちらまでお問い合わせください。
個人情報保護方針(プライバシーポリシー)
- 個人情報に関する法令・規範を遵守します。
- 当社はお客様の個人情報への不正アクセス、紛失、破壊、改ざん及び漏洩等の防止に努めます。
- 個人情報は法令に基づき開示される以外は、個人情報をお客様に明示した利用目的の範囲内で取扱い、第三者に譲渡、提供はしません。
- 当社は個人情報保護に対する取組みを継続的に見直し、適宜改善します。